Epoxy Molding Compounds
for Substrate

This type is suitable for BGA and CSP, and has low warpage and excellent reflow crack resistance. It is also applicable for packages with narrow pad pitch and long wire.
Features
Applications
- Small warpage after molding
- Excellent reflow crack resistance
- Applicability to mold underfilling process
CSP, BGA, Stacked MCP and etc.
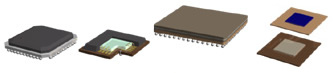
Characteristics
| Item | Unit | CEL-1702 HF13 | CEL-1802 HF19 | CEL-9700 HF10 | CEL-9750 HF10 | CEL-9750 ZHF10 |
GE-100 | GE-110 | |
|---|---|---|---|---|---|---|---|---|---|
| Applications | — | BOC | BOC | BGA, CSP | |||||
| Flame retardant type | — | Metal hydroxide | Organic phosphorous | No flame retardant | No flame retardant | No flame retardant | Metal hydroxide | Metal hydroxide | |
| Spiral flow | cm | 90 | 90 | 110 | 145 | 150 | 190 | 165 | |
| Tg | °C | 125 | 120 | 125 | 140 | 150 | 145 | 155 | |
| CTE | α1 | ppm/°C | 12 | 9 | 6 | 7 | 7 | 9 | 9 |
| α2 | ppm/°C | 45 | 36 | 27 | 29 | 27 | 38 | 35 | |
| Flexural modulus | GPa | 16 | 17 | 27 | 27 | 26 | 23 | 22 | |
| Mold shrinkage | % | 0.32 | 0.35 | 0.10 | 0.10 | 0.08 | 0.10 | 0.08 | |
Process

